Наиболее важные с практической точки зрения результаты были достигнуты при исследовании спинового транспорта в металлических мультислойных структурах. Как мы видели, эффект гигантского магнитосопротивления обусловлен зависимостью рассеивания электронов от типа магнитного упорядочения смежных слоев в пленке. Аналогичный спин-зависимый эффект наблюдается в структурах с магнитным туннельным переходом (Magnetic Tunnel Junction, MTJ) типа ферромагнетик — диэлектрик — ферромагнетик (подробнее о них чуть ниже). Он также может приводить к большому туннельному магнитосопротивлению, ТМС (Tunnel Magnetoresistance, TMR). Наноразмерные магнитные структуры с эффектами ГМС и ТМС нашли широчайшее применение в сенсорах магнитного поля, считывающих головках жестких дисков и энергонезависимой магниторезистивной памяти (Magnetic Random Access Memory, MRAM). Рассмотрим более подробно материалы, в которых наблюдаются гигантские магниторезистивные эффекты.
Спин-вентили
Очередным шагом на пути совершенствования структур с ГМС стали спиновые вентили (СВ). Они также состоят из двух магнитных слоев, разделенных немагнитной прослойкой, но магнитный момент одного из слоев закреплен антиферромагнитным слоем (АФМ) с фиксированным направлением магнитного момента. В то же время намагниченность второго слоя может свободно изменяться под действием внешнего магнитного поля. В другом варианте СВ имеют структуру пермаллой (NiFe)/медь (Cu)/ кобальт (Co), рис. 6. Когда мы помещаем этот «сэндвич» даже в слабое магнитное поле, верхний «свободный» слой легко изменяет конфигурацию магнитных моментов вслед за полем, выстраивая ее антипараллельно нижнему слою. А если есть такой переход, то будет и гигантское магнитосопротивление. На основе таких элементов созданы считывающие магниторезистивные головки в жестких дисках с плотностью записи более 100 Гбайт/кв. дюйм.
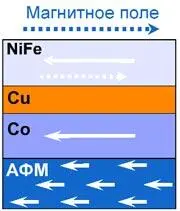
Варьируя материал, толщину и последовательность слоев, можно оптимизировать магнитные и электрические свойства таких наноструктур и расширить область их практического применения. За несколько лет, прошедших с момента открытия спиновых вентилей, было создано и исследовано не менее одиннадцати их видов с различной структурой.
Магнитный туннельный переход
К следующему поколению спинтроники относят структуры, принцип действия которых основан на явлении магнитного туннельного перехода. Магнитный туннельный переход происходит в структуре, состоящей из двух слоев ферромагнетика, разделенных изолятором (обычно это оксид алюминия Al2O3). Причем толщина изолятора так мала (менее 2 нм), что электрон может просачиваться через него — этот процесс называется туннелированием. В ферромагнитном материале энергия электронов со «спин-вверх» и «спин-вниз» различная, поэтому и вероятность их туннелирования будет отличаться. Если магнитные моменты смежных слоев направлены параллельно, проводимость магнитного туннельного перехода велика, а если намагниченности антипараллельны, то вероятность туннелирования мала, то есть электросопротивление большое. Таким образом, имеются условия для возникновения эффекта ГМС. Максимальная величина магниторезистивного эффекта, наблюдаемого в таких структурах при комнатной температуре, составляет около 220%.
Структуры с магнитным туннельным переходом применяются в качестве считывающих головок в жестких дисках, а также для создания элементарных ячеек магниторезистивной оперативной памяти (MRAM). MRAM-память выглядит весьма перспективной и многообещающей по сравнению с другими типами энергонезависимой памяти. Так, например, время выборки данных у MRAM-памяти может составлять 10 нс, что в пять раз меньше, чем у flash-памяти, а время записи — 2 нс (на три порядка меньше, чем у flash-памяти). При этом энергопотребление магниторезистивной памяти вдвое меньше, чем у flash— и DRAM-памяти.
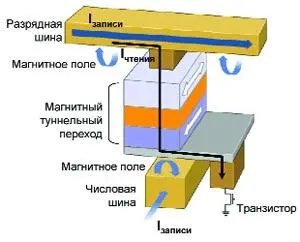
Сегодня разработку MRAM-памяти ведут несколько фирм: Motorola, IBM, Infineon, Cypress Semiconductor, TSMC, а также совместно NEC и Toshiba. Большинство из них остановились на MRAM-памяти с магнитным туннельным переходом. Схема ячейки памяти, в которой перемагничивание осуществляется по методу Савченко, разработанному в компании Motorola, представлена на рис. 7. Ячейка памяти сформирована на пересечении разрядной и числовой шин. Она состоит из структуры с магнитным туннельным переходом, которая отвечает за хранение информации, и транзистора, с помощью которого организована адресация. Существуют схемы, в которых транзистор заменен диодом или вообще отсутствует. Ток, протекающий по разрядной и числовой шинам, наводит перекрестное магнитное поле, которое изменяет магнитное состояние свободного слоя. При считывании измеряется ток, протекающий через ячейку. Его величина зависит от конфигурации намагниченности магнитных слоев структуры: при параллельной ориентации сопротивление перехода минимально. Это соответствует логическому "0". При антипараллельной ориентации намагниченностей сопротивление велико, туннельный ток мал — это логическая "1".
Читать дальше